Probing Nanoscale Realms: Unveiling Material Mysteries with Scanning Microwave Impedance Microscopy
April 1, 2024 @ 11 AM - 12 PM
Ryan Hall #4003 - Evanston Campus
Principles and applications of Scanning Microwave Impedance Microscopy (sMIM), a powerful technique for characterizing materials at the nanoscale.
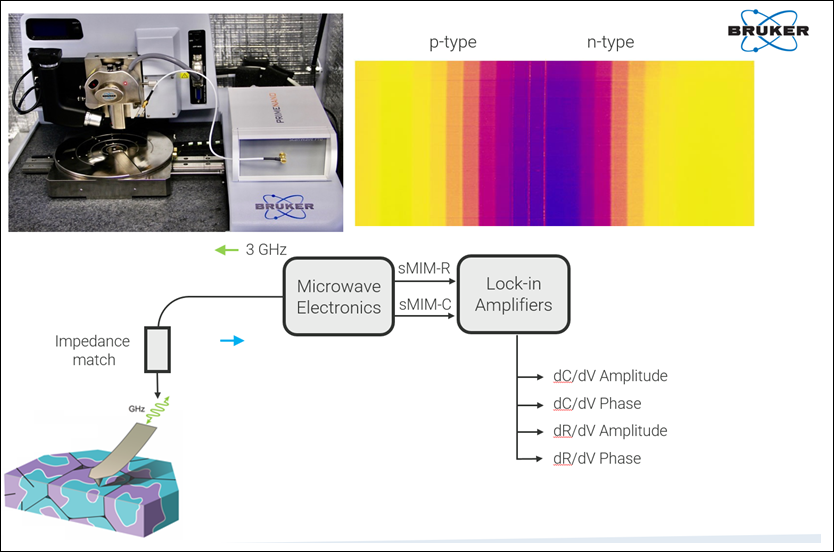
sMIM utilizes an Atomic Force Microscopy (AFM) cantilever as a microwave source to measure the local variation in dielectric properties of materials. By employing shielded cantilevers, background capacitance is reduced, enhancing spatial resolution. The technique is sensitive to changes in capacitance and conductivity, making it suitable for a wide range of materials, including insulators, semiconductors, and ferroelectric materials.
sMIM can operate in various AFM modes, such as Tapping, Contact, and PeakForce mode, providing flexibility in characterization. Moreover, its ability to penetrate deeper into the sample surface enables the characterization of sub-surface features.
The talk promises to review the current state of sMIM technology, presenting various applications and case studies to demonstrate its versatility and effectiveness in material characterization.

